



電子機器の高性能化・高速化に伴い、SiインターポーザやFan-outパッケージなどに代表される、異なるICチップを一つのパッケージに実装するヘテロジニアス構造がさらに注目されています。新光電気は、半導体パッケージ用基板の更なる微細化や有機インターポーザ向け技術として、プラズマ技術、スパッタ技術、フォトリソ技術を用いた微細配線やフォトビアの開発をしています。
半導体パッケージ用基板の製造プロセスとICチップの製造工程で使用する技術を融合することで、基板上に最先端を行く銅の微細配線、感光性絶縁樹脂を用いたフォトビア形成を可能とします。
半導体パッケージ用基板で、無電解めっきシード層に替わるスパッタリング膜および電解銅めっき前の親水化としてプラズマ処理を導入しました。電解銅めっきのパターニングレジスト除去後に、クリーニングのプラズマアッシング処理の導入により、細線幅1.5μmを実現しました。
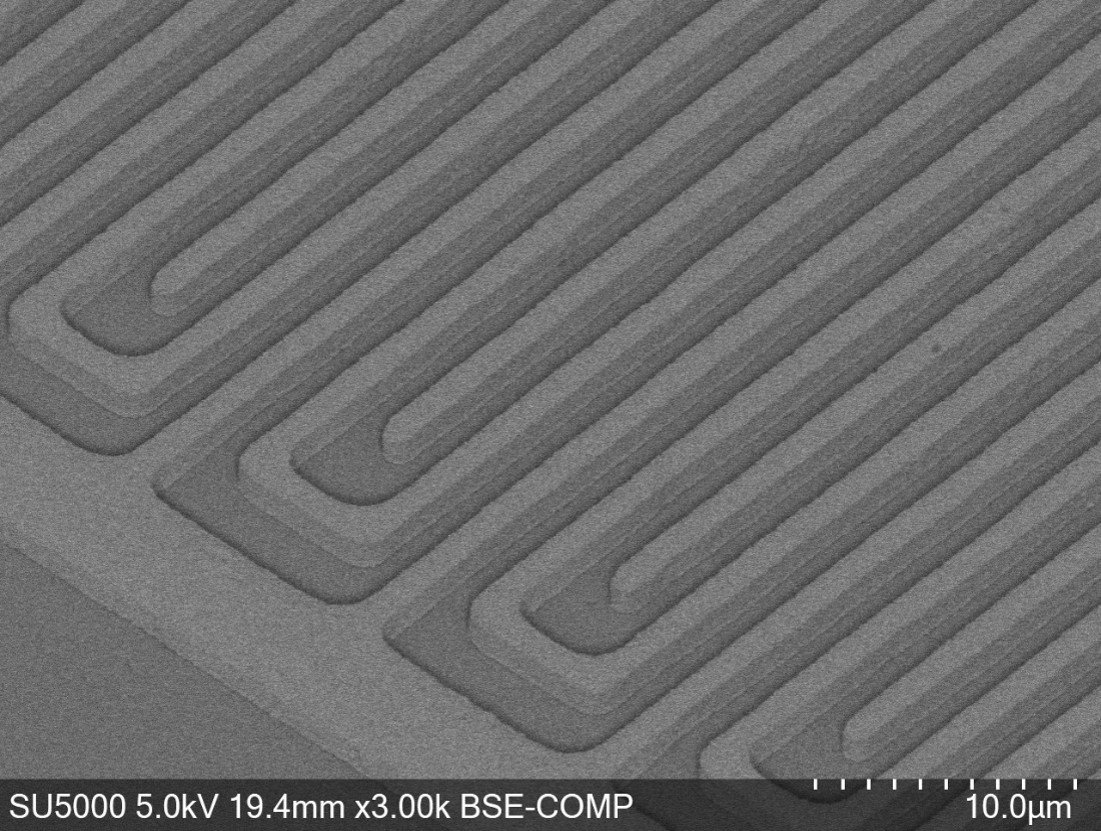 Line/Space=1.5μm/1.5μm
Line/Space=1.5μm/1.5μm小林 祐輝, 滝沢 優哉, 山崎 智生, 清水 規良, “樹脂とシリカフィラーが露出されたコンポジット材料表面へのスパッタリングシード形成に関する一考察”、第37回エレクトロニクス実装学会春季講演大会、2023.03.
