



今後さらに加速するSoC(System on Chip)化のソリューションとして、ヘテロジニアス構造や3Dスタックパッケージ等が提唱されています。新光電気は、半導体パッケージで培っためっき技術、薄膜技術等を融合して、それらを実現するための狭ピッチのフリップチップバンプ技術を開発しています。
新光電気のめっき技術を活用して、有機基板の最終表面処理として高い接合信頼性を有するNi/Pd/Auめっきプロセスを用いた次世代向けピッチ30μm、パット径20μmのバンプ構造を開発しました。
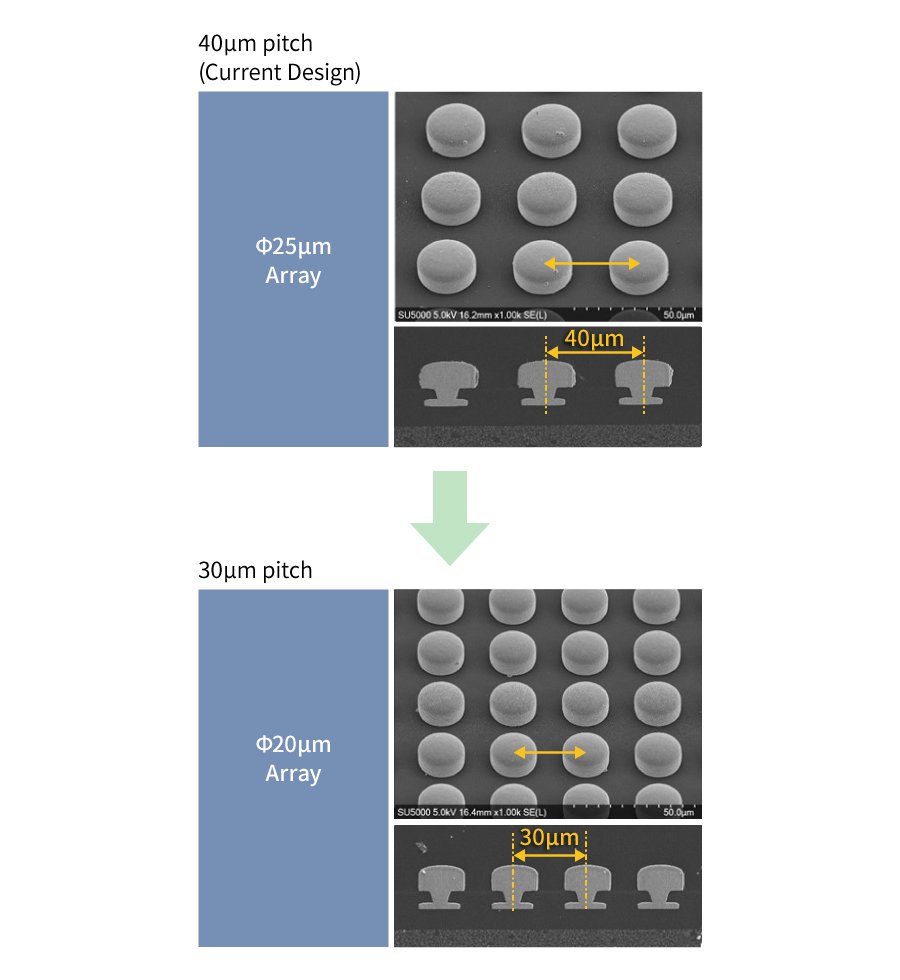
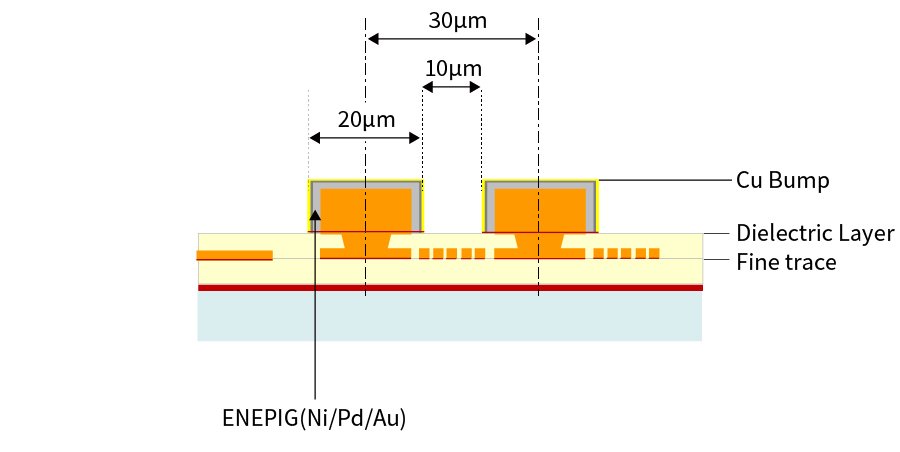
その他、次世代技術としてより狭ピッチで高い実装信頼性が得られる構造やはんだを用いた構造の接続端子の開発も進めております。
Cuバンプ上に直接無電解Pd/Auめっきを行うことにより、良好なめっき析出性と実装信頼性が得られます。従来の構造に比べてNi層が無いために狭ピッチ化の実現が可能です。
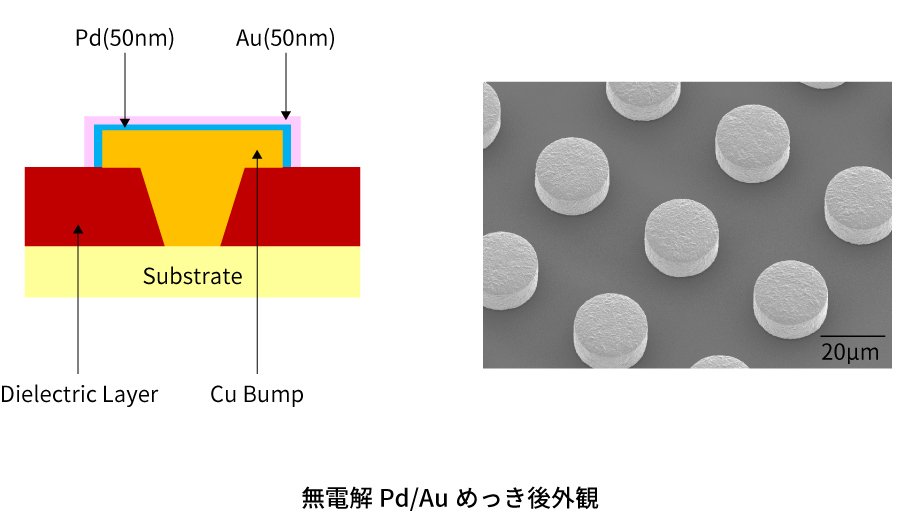
Ni/SnめっきをCuバンプ上に直接形成することで、トップ面のみはんだを実現します。近年ICチップの大型化に伴い、実装時の反り・うねりといった課題が顕在化していますが、これらの課題に半導体パッケージ用基板側からのソリューションを提供します。