
SHINKO ELECTRIC INDUSTRIES CO., LTD.

SHINKO ELECTRIC INDUSTRIES CO., LTD.
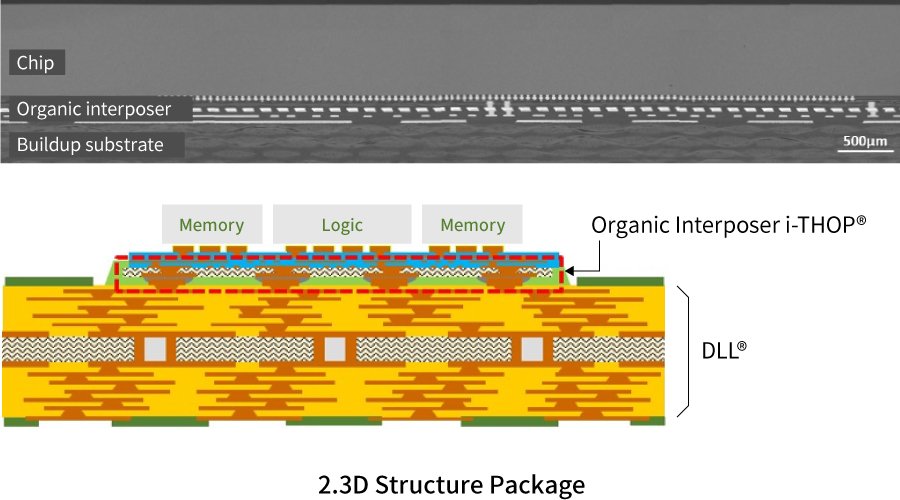 * “i-THOP” and ”DLL” are registered trademarks of SHINKO ELECTRIC INDUSTRIES CO., LTD.
* “i-THOP” and ”DLL” are registered trademarks of SHINKO ELECTRIC INDUSTRIES CO., LTD.
Since assembly technology can produce packages with heterogeneous structure, its role has been ever expanding in recent years.
SHINKO offers semiconductor-package assembly solutions to provide Beyond 5G and 6G technology by using advanced fine-pitch flip-chip assembly technology and its application.
SHINKO is developing advanced assembly technologies for next-generation semiconductor packages.
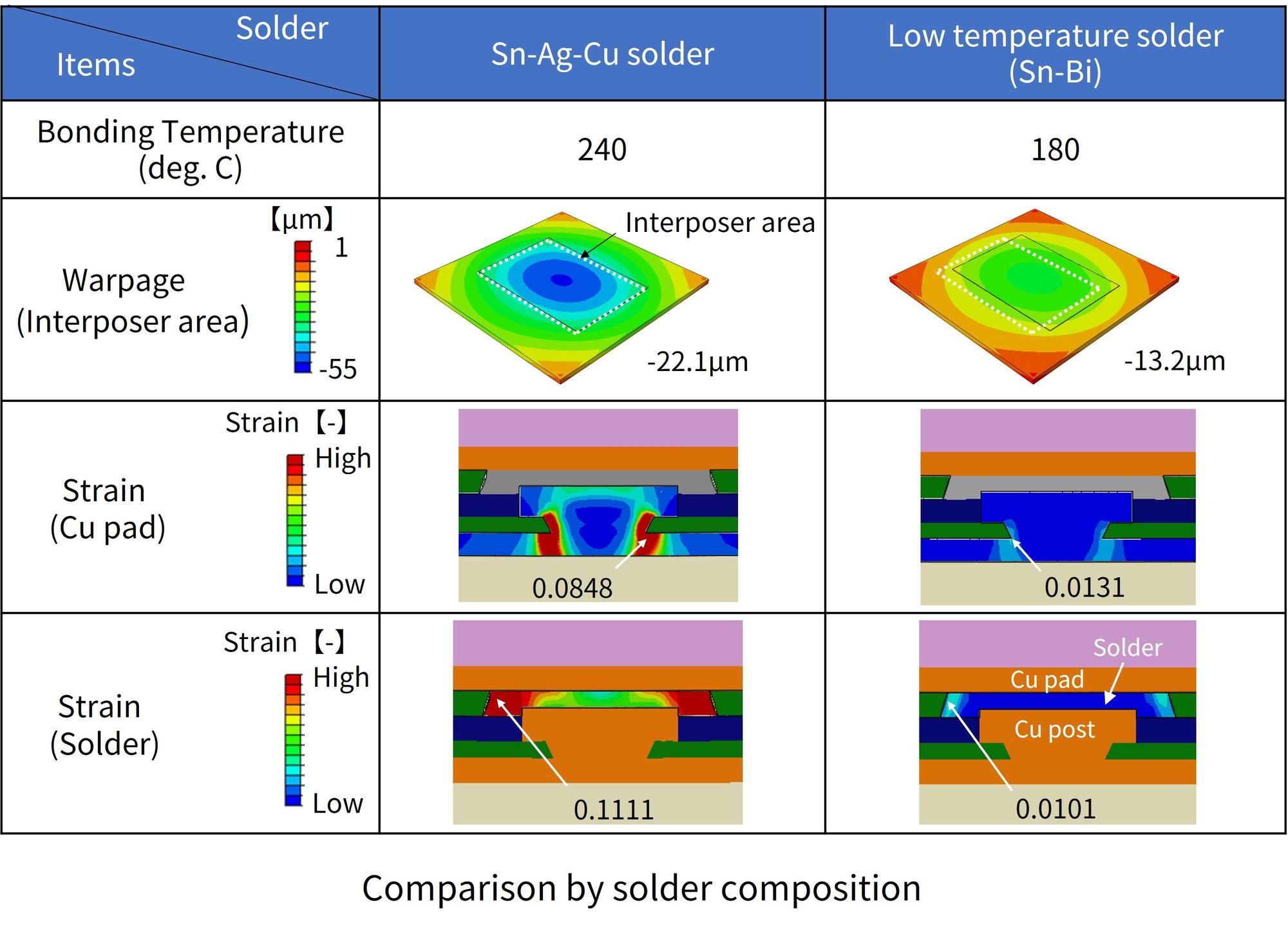
1. “Demonstration of 2.3D Organic Package with Increased Interposer Size and Layer Count”, Kosuke Tsukamoto, Wataru Kaneda, Masayuki Mizuno, Manabu Nakamura, Yuta Yamazaki, Koyuki Kawakami, Yoshihiro Kobayashi, and Atsunori Kajiki, The 20th International Symposium on Microelectronics and Packaging (ISMP2022).
2. “Development of High Reliability Joint of Sn-Bi Solder for 2.3D Organic Package”, Shota Miki, Koyuki Kawakami, Kei Murayama and Kiyoshi Oi, ICEP (International Conference on Electronics Packaging) 2021.
3. “Effect of crystal anisotropy and IMCs on electro-migration resistivity of low temperature flip chip interconnect”, Kei Murayama, Mitsuhiro Aizawa, Kiyoshi Oi, ECTC (IEEE Electronic Component and Technology Conference) 2021.
4. “Environmental load reduction technology using low-temperature solder for high-performance semiconductor packages”, Kei Murayama, Mitsuhiro Aizawa and Kiyoshi Oi, Electronics Goes Green 2020+.