
SHINKO ELECTRIC INDUSTRIES CO., LTD.

SHINKO ELECTRIC INDUSTRIES CO., LTD.
Search by Product Name
Search by Application
To Our Shareholders
IC Assembly
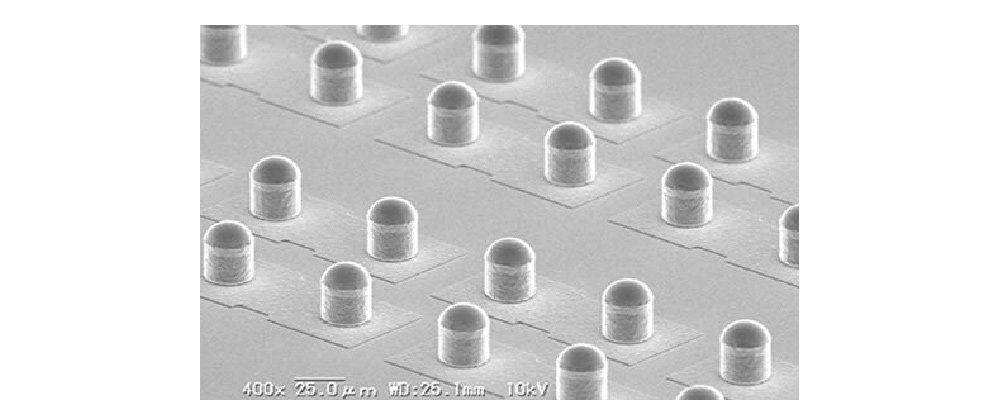
Copper pillars are terminals used to “flip-chip” IC chips to a substrate in a semiconductor package by TCFC (Thermal Compression Flip-Chip) technology. Copper pillars are formed on aluminum electrode pads of an IC chip. Copper pillar interconnects are seeing higher demand due to an increase in pin count with fine pad pitches integrated on an IC chip.
Copper pillars with dimensional uniformity can be formed on a silicon wafer by using fine plating pattern forming technology.